圖研將貢獻面板級有機中介層專用設計製造流程驗證與工具開發
圖研株式會社(代表取締役社長:勝部迅也,以下簡稱圖研)宣布加入次世代半導體封裝聯盟「JOINT3」。
JOINT3是由Resonac株式會社(代表董事社長兼CEO:高橋秀仁,以下簡稱Resonac)所設立的共創型評估平台,旨在透過材料、設備與設計等企業的協作創新,加速開發適用於面板級有機中介層的材料、設備及設計工具。
JOINT3匯聚半導體材料、設備及設計領域的世界頂尖企業,將運用515 x 510mm尺寸的 面板級有機中介層試作產線,推動適用於 面板級有機中介層的材料、設備及設計工具開發。
圖研將憑藉作為EDA供應商,利用支援客戶尖端封裝設計的實績與技術實力,參與JOINT3計畫中針對面板級有機中介層的次世代半導體封裝設計、製造與評估實務。同時透過開發解決過程中顯現課題的工具與功能,致力建立最優化的設計製造流程。
近年來,隨著生成式AI及電動車的市場急速擴大,次世代半導體的後端製程封裝已成為下一代半導體領域的關鍵技術。這其中包括2.xD封裝(將多個半導體晶片並行排列並透過中介層連接)。隨著資料通信容量和速度需求的成長,此類封裝的需求預計將持續上升。隨著半導體效能提升,中介層尺寸不斷增大,市場正從矽中介層向有機材料製成的有機中介層轉型。
傳統製造方法從圓形晶圓切割矩形組件。然而,隨著中介層尺寸增大,單晶圓可產出的中介層數量減少,構成重大挑戰。為解決這一問題,從圓形晶圓向方形面板轉型的製造製程備受關注,因其可在相同晶圓面積內生產更多的中介層。
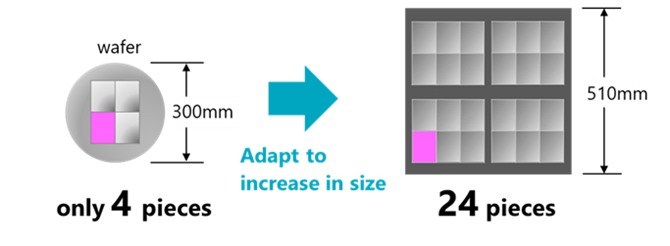
圖研除為客戶提供尖端封裝設計環境外,亦參與多項2.xD封裝與3D封裝的設計製造驗證專案。在此過程中,我們在半導體積層、有機材料積層以及各類中介層組裝等技術領域,累積了豐富的設計支援與工具開發實績。這些經驗與技術已整合至CR-8000 Design Force的2.5DIC/3DIC設計驗證功能,以及SoC/封裝/印刷電路板協同設計環境中。
在JOINT3計畫中,圖研將運用CR-8000 Design Force平台,致力於透過面板級有機中介層實現次世代半導體封裝設計與製造的實踐與評估。除物理結構與佈線設計驗證外,更規劃開發新功能,包含設計階段即考量各類材料物性與特性的預判驗證機制。
今後,我們將透過JOINT3計畫和參與企業共同創新,致力推動採用面板級有機中介層的次世代半導體封裝設計、製造與評估流程之進化,期待能成為次世代生態系統與供應鏈的重要支柱。

JOINT3 標誌(參與企業聯合標誌)
【JOINT3概要】
- 名稱:JOINT3(JOINT:頂尖實證開放創新網絡)
- 目的:
透過和參與企業共同創新,加速開發適用於面板級有機中介層的材料、設備及設計工具 - 參與企業:按字母順序排列共27家(截至2025年9月3日)
Resonac株式會社、AGC株式會社、Applied Materials, Inc.、ASMPT Singapore Pte. Ltd.、Brewer Science, Inc.、
Canon, Inc.、Comet Yxlon GmbH、荏原製作所株式會社、古河電氣工業株式會社、日立高新株式會社、
JX金屬株式會社、花王株式會社、Lam Research Salzburg GmbH、LINTEC株式會社、MEC株式會社、
三豐株式會社、納米克斯株式會社、日鋼材料株式會社、奧野製藥工業株式會社、
新思科技股份有限公司(日本窗口:安世半導體日本股份有限公司)、東京電子株式會社、東京應化工業株式會社、
TOWA株式會社、ULVAC株式會社、Ushio Electric株式會社、Zuken株式會社、3M Company - 據點
・尖端面板級中介層中心「APLIC(Advanced Panel Level Interposer Center)」
(茨城县結城市,Resonac下館事業所(南結城)內)
・封裝解決方案中心(神奈川縣川崎市) - 活動內容
・運用面板級(515 x 510mm)試作產線,開發適用於有機中介層的材料、設備及設計工具
・材料與設備製造商共同製作共通試作品,透過協創推進開發進程
・技術與設備廠商將JOINT3作為「練習場」,精進面板級有機中介層相關技術