為您介紹開發3D大規模積體技術的WOW聯盟的投入研究
圖研以東京工業大學科學技術創成研究院的特聘教授大場隆之為中心,參與投入次世代半導體研發的產學研究平台「WOW聯盟」,並推動共同開發獨創的3D大規模積體技術。
據說,目前半導體開發已到達利用精密化來提高性能的極限,因此對於垂直堆疊晶片後再實裝的3D實裝技術的期待便越來越高。另一方面,利用3D積體來提高性能的同時,所要求的是減少耗電量與降低熱電阻,WOW聯盟為了解決這些課題,正在投入開發新的小晶片積體技術。
WOW聯盟將以往20~30μm的晶圓壓薄到4μm的獨創「晶圓薄化技術」、不使用凸塊進行TSV配線的「無凸塊配線技術」、透過高密度超並聯配線進行的「兆位元組高頻寬傳輸」應用至WOW (Wafer on Wafer) 和COW (Chip on Wafer) 的堆疊,確立了3D大規模積體技術「BBCube」。我們也正在積極研發,希望這項技術成熟後,可將半導體系統縮小至1000分之1,耗電量減少至1000分之1以下。
圖研在這項3D積體電路的實裝設計中,運用多電路板設計環境「CR-8000 Design Force」來支援技術開發。
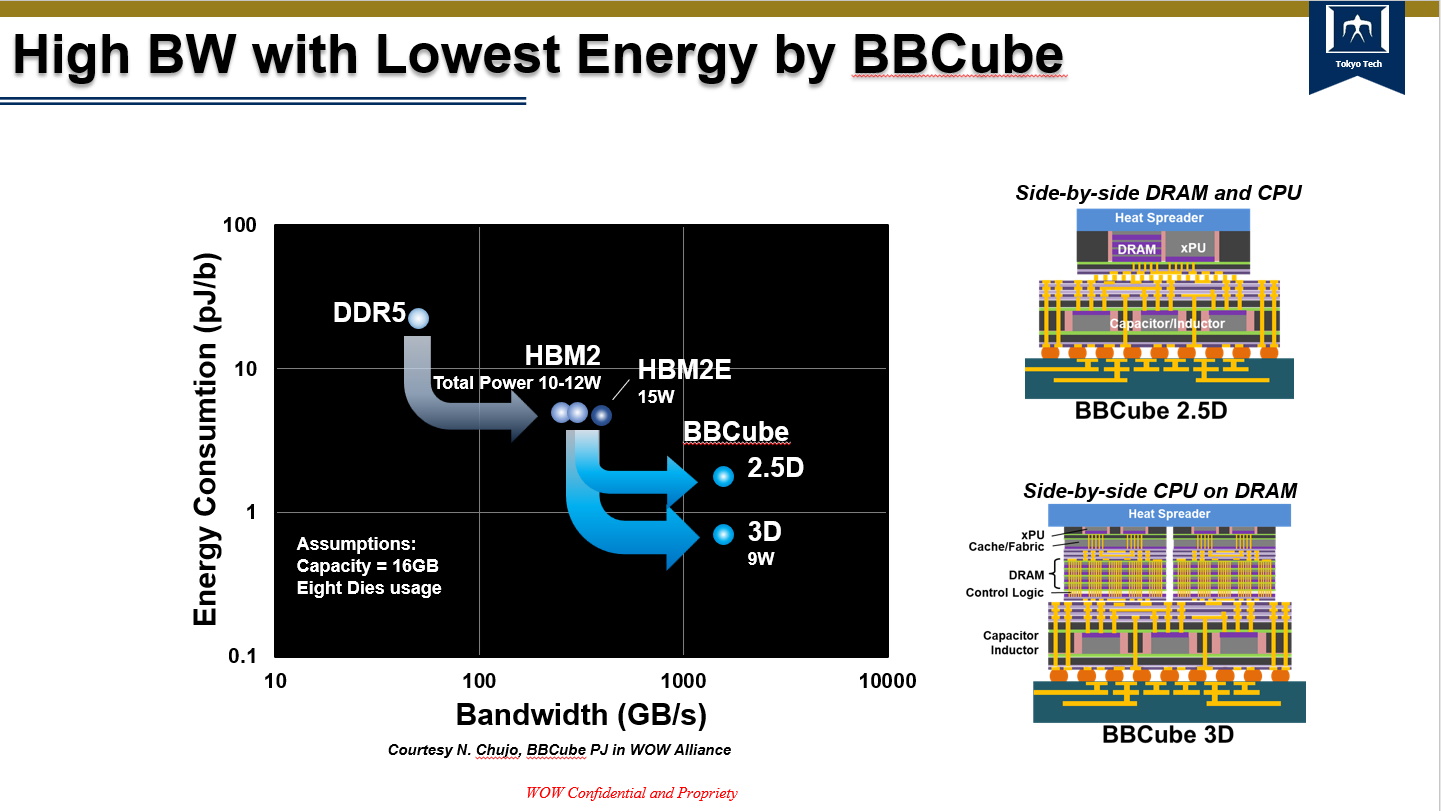 |
 |